About mobility degradation in MOSFETs, and the carrier velocity saturation model.
Effect of Gate Voltage on Carrier Motion
The previous given equations to calculate
Electrons moving in the channel are under the influence of two electric fields: the vertical field from the gate, attracting it to move vertically towards the gate oxide, and lateral field from the drain, attracting it to move laterally towards the drain.
The electron will bounce off the silicon and oxide interface a few times before reaching the drain. If the vertical field is strong, electrons will bounce more times off the surface. The collision between the electron and the interface is inelastic, causing energy loss and reducing the velocity of the electron. Therefore, it will take longer time for electrons to reach the drain.
Thus, the mobility
To correct for this effect,
The Effective Vertical Electric Field
To quantify the variation of
Electrons at different distance from the interface will experience different vertical electric field. To simplify the problem, the average electric field is used, assuming it to be the electric field experienced by all electrons.
- The average vertical electric field is
- An intuitive derivation of this equation:
- The average electric field can be considered the electric field experienced by an average electron
- The average electron is the one with half of the electrons in the channel above it, and half below it
- The electric field starts at a positive charge at the game, and terminates at a negative charge at the substrate
- Electric field terminating above the average electron will not be experienced by the average electron
- Therefore, only the electric field terminating below the average electron will be experienced by the average electron
- Once the charge
- The charge
- Half of the inversion charge
- The entire depletion charge
- Half of the inversion charge
- Thus the equation is obtained
- We need to further express
- The inversion charge density is
- The depletion charge can be calculated with the following equation
- The effective vertical electric field can now be expressed as
- Once
- The inversion charge density is
Calculating Effective Mobility
We still need to obtain the relation between
There are many theories predicting the effective mobility based on the microscopic effects, but none of them fit the experimental data well.
In practice, engineers rely on experimental calibration to obtain the effective mobility. Experimental data are collected are plotted:
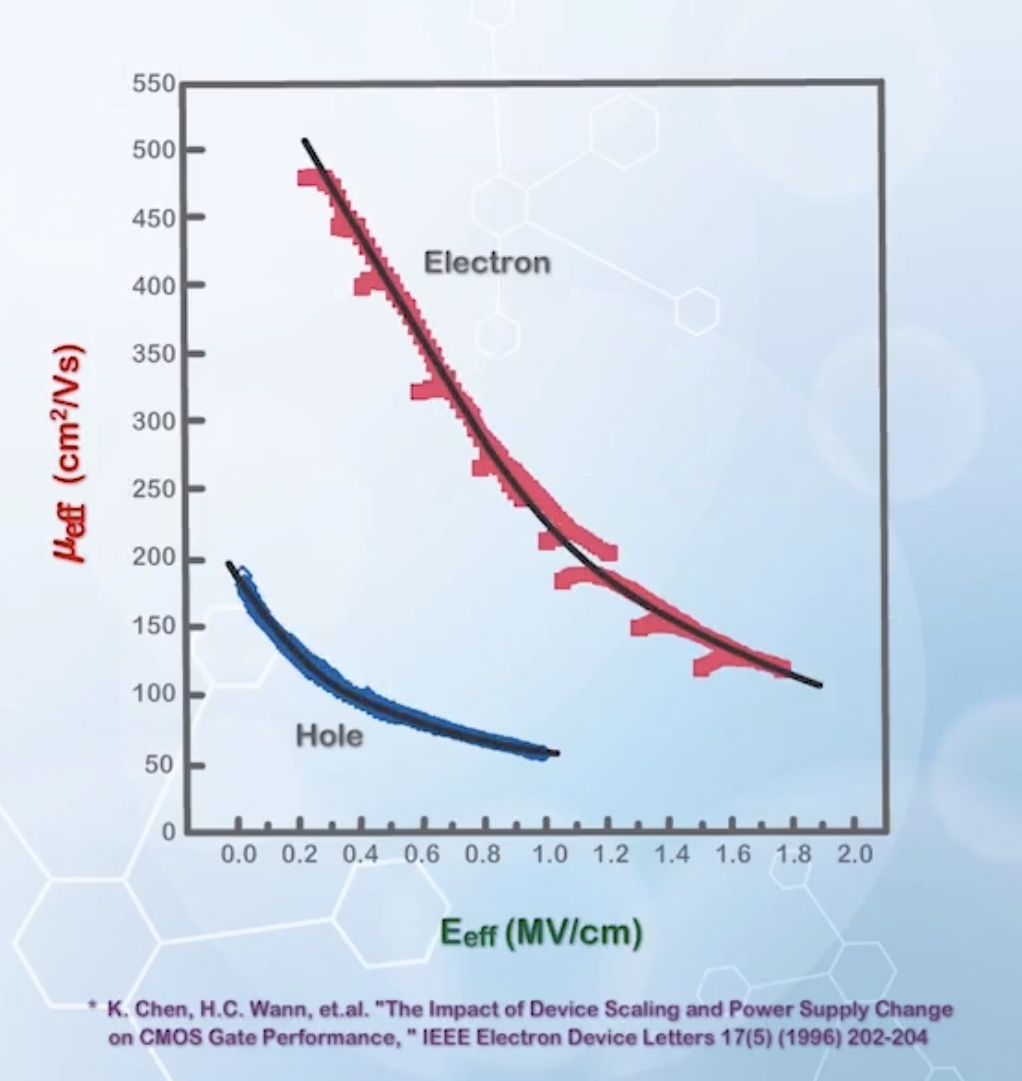
Regardless of the gate oxide thickness and the substrate doping concentrations, they all fall onto a single curve.
As the results are very consistent, an empirical equation is more practical to use, rather than complex theoretical models.
The empirical equation is given as
and a widely used set of parameters for this model is
| Electrons | Holes | |
|---|---|---|
Some other sets of parameters are also used, due to variations in the fabrication process and the physical structure.
This is the universal mobility model, as it can fit different sets of data very well.
The relationship between
Now we can plot
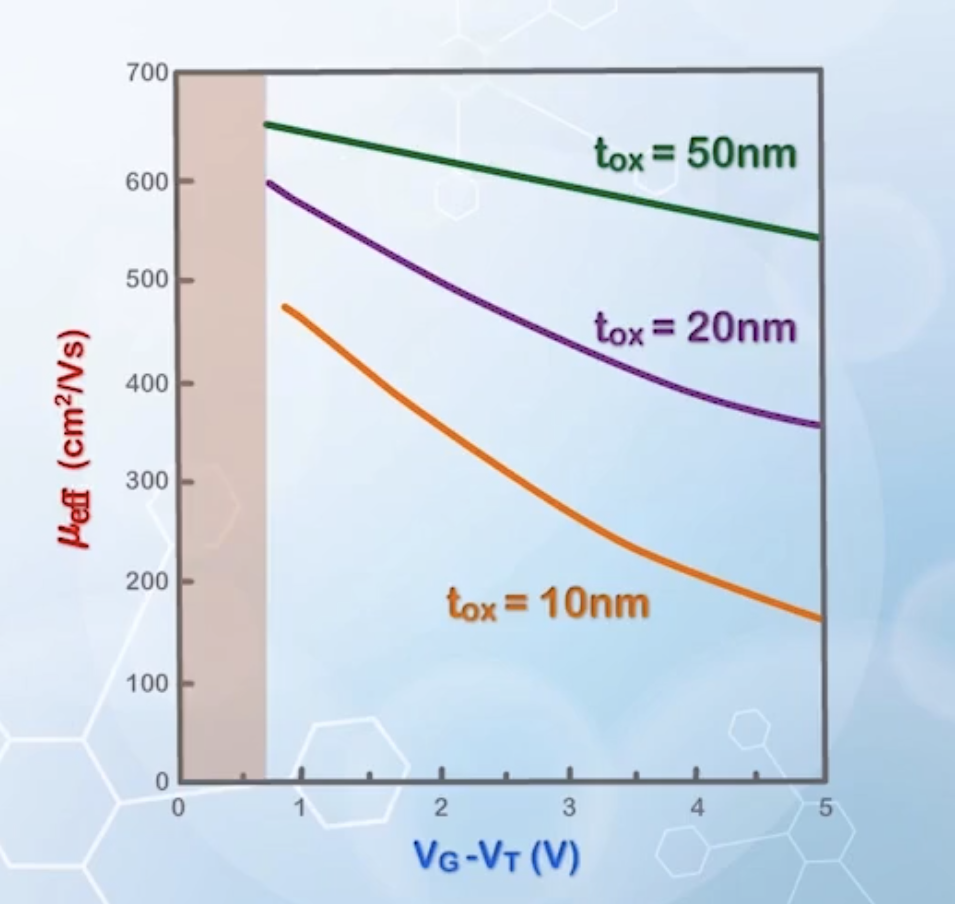
Note that the model may not be accurate for
From the graph, we can see that when
thinner oxide thickness will lead to larger
Therefore, the mobility degradation effect may not be important for older MOSFETs with thick oxide, but it is very important for modern MOSFETs with thin oxide.
The

Compared to constant
Carrier Velocity Saturation Model
Up to now, we have linearly related the carrier velocity
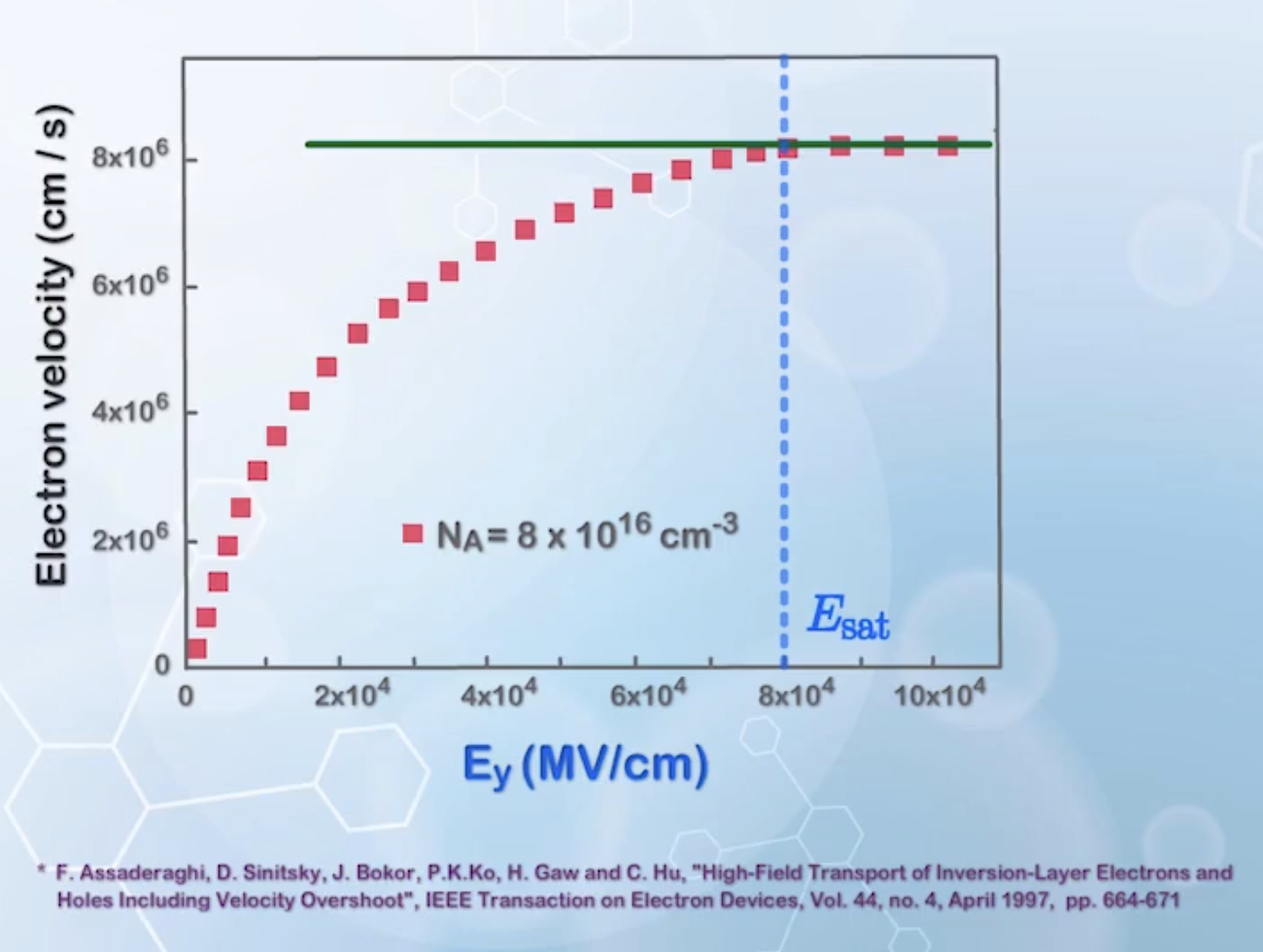
From measurements, carrier velocity saturates at a certain electric field
To include this effect in drain current calculation, we need to derive a new expression for carrier velocity
The easiest way is to use a straight line to connect the two known points: (0,0) and
To be more accurate, the slope of the curve, or mobility, should decrease when the lateral electric field increases, so a better expression would be
The slope will be decreasing with increasing
providing better fitting for the data.
We have the measured
where
To derive the new drain current equation considering velocity saturation
Compared to the classical model, there is just an additional factor of
As for the saturation region, we define
Carrier Velocity Saturation v.s. Pinchoff
Comparing the two set of equations
- The pinchoff model
- The carrier velocity saturation model
- In the linear region, the two models are very similar, with just an additional factor in the carrier velocity saturation model that reduces the increase in
- The new
- Carrier velocity saturation will kick in before pinchoff occurs, preventing pinchoff from happening
- This is because the carrier velocity saturation limits the maximum carrier velocity, preventing the carrier density from reaching zero at the drain end, as
- This removes the inconsistency in the pinchoff model that requires infinite carrier velocity
The problem of the pinchoff model is that it does not provide a clear physical image for the ending of the gradual channel region, and we arbitrarily picked
By providing a more physical definition for the end of the gradual channel region, the carrier velocity saturation model avoids reaching the pinchoff condition, and thus solved the problem.
Also, the saturation current in the carrier velocity saturation model is also physically derived, instead of extending the flat portion of the linear region equation of the drain current, and
The same substrate charge factor